2023年6月13日
日本電信電話株式会社
国立大学法人東京工業大学
世界初300GHz帯でのビームフォーミングと高速データ伝送に成功
~端末への超大容量データ瞬時転送の実現に向けた要素技術の確立~
日本電信電話株式会社(本社:東京都千代田区、代表取締役社長:島田 明、以下「NTT」)と、国立大学法人 東京工業大学(東京都目黒区、学長:益 一哉、以下「東工大」)工学院 電気電子系の岡田健一教授らは、2030年代の6Gに向けて300GHz帯のフェーズドアレイ送信モジュールを開発し、ビームフォーミングを用いた300GHz帯高速無線データ伝送に世界で初めて成功しました。本技術により、移動する受信端末に向かって超大容量データを瞬時に転送できるようになります。
本技術の詳細は2023年6月11日からアメリカ、サンディエゴで開催される国際会議IMS2023 (2023 IEEE MTT-S International Microwave Symposium)で発表予定です。
 図1:(左)フェーズドアレイ無線機によるビームフォーミングのイメージ図、
図1:(左)フェーズドアレイ無線機によるビームフォーミングのイメージ図、
(右)従来報告されているビームフォーミング可能な無線機と今回成果の比較
1.研究の背景
第6世代移動通信システム(6G)では300GHz帯の電波を活用した高速無線通信が期待されています。300GHz帯の電波は広い帯域を利用できるメリットがある一方、空間を伝搬する際の電波損失が大きいという課題があります。その課題を克服するために従来では受信端末が存在する方向に向けて電波のエネルギーを集中させて放射するビームフォーミング技術が検討されています。ビームフォーミング技術は、28GHz帯や39GHz帯の電波を使用する5G無線システムにおいてCMOS-IC(※1)によって実現されてきました。一方で300GHz帯においてCMOS-ICのみでは出力電力が不足(※2)するため、高出力なIII-V族の化合物IC(※3)との組み合わせによってビームフォーミング技術を実現することが世界中で期待されています。しかしながら、化合物IC内やCMOS-ICとの接続部で発生する大きな損失が高出力化を阻害するため、 300GHz帯でビームフォーミングによる高速無線データ伝送はまだ実現されていません。
2.研究の成果
今回、東工大では周波数変換回路や制御回路等を搭載した高集積なCMOS-ICを作製し、NTTではNTT独自のインジウム・リン系ヘテロ結合バイポーラトランジスタ(InP HBT)技術(※4)で高出力なパワーアンプ回路とアンテナを一体集積したInP-ICを開発しました。さらに前記CMOS-ICとInP-ICとを同一プリント基板上に小型実装した4素子フェーズドアレイ送信モジュール(※5)を実現しました。本送信モジュールは36度の指向性制御範囲と通信距離50cmにて最大30Gbpsのデータレートを達成し、300GHz帯において、ビームフォーミングを用いた高速無線データ伝送に世界で初めて成功しました(図1右)。
3.技術のポイント
本成果では以下の2つの高出力化技術により、ビームフォーミングと高速無線データ伝送を可能にしました。
・300GHz帯高出力パワーアンプ回路の設計
300GHz帯で高い出力電力を実現可能なパワーアンプ回路(※6)を設計し、NTT独自のInP HBT技術で製造しました。パワーアンプ回路では複数の増幅素子から出力される電力を独自の低損失合波器を用いて束ねることによって高出力化を図りました。本回路によりCMOS-ICから出力される信号を増幅し同一チップ上に形成されたアンテナから受信端末に向けて電波を放射することにより、高速データ伝送に必要な大きな電力を受信端末に送り届けることができます(図2)。
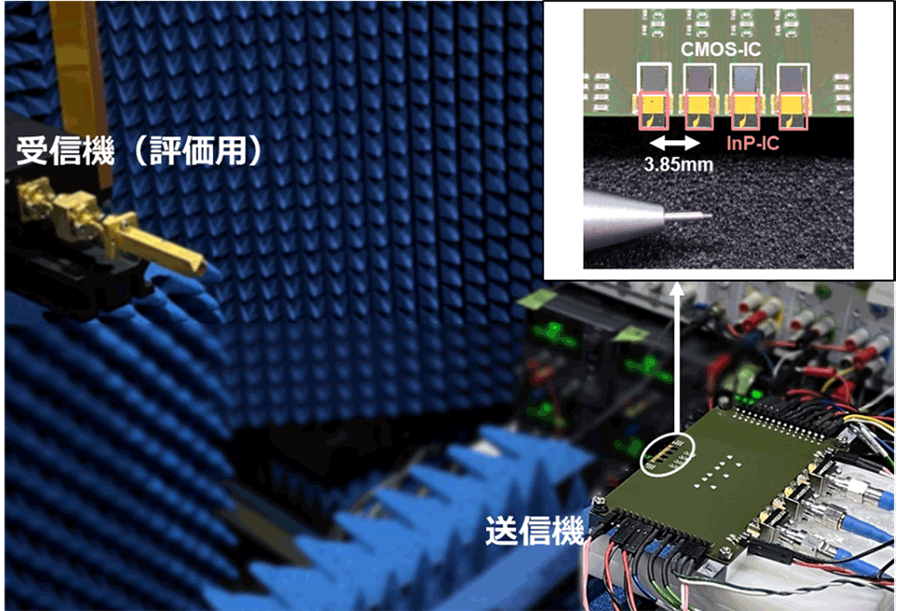 図2 今回開発した300GHz帯フェーズドアレイ送信機と伝送特性実験時の写真
図2 今回開発した300GHz帯フェーズドアレイ送信機と伝送特性実験時の写真
・高周波帯低損失実装技術
従来、300GHz帯で異なる種類のIC同士を接続するためには、それぞれのICを導波管モジュール(※7)に実装し接続することが一般的ですが、導波管を通過する際に生じる損失が問題となっていました。本成果では、両者を同一基板上にフリップチップ実装(※8)し、数十µmの微小な金属バンプを介して接続する工夫を施しました。それによって接続損失を低減し、高出力化を実現しています(図3)。
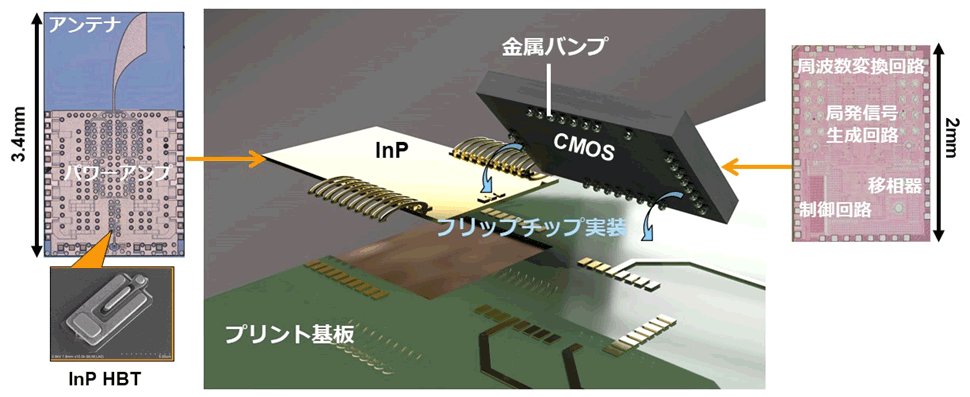 図3 300GHz帯フェーズドアレイ送信機の3次元分解図およびチップ写真
図3 300GHz帯フェーズドアレイ送信機の3次元分解図およびチップ写真
4.今後の展開
今回の成果は6Gのアプリケーションとして期待されているKIOSKモデルやFemtocell等の近距離移動体通信への展開が期待される技術です。本成果は1次元のビームフォーミングの実証でしたが、今後は2次元アレイ化よる2次元ビームフォーミングの実証やアレイ数を増やすことによる通信距離の拡張等に取り組みます。また利用用途に応じた受信モジュールの開発にも取り組み、従来よりも10倍以上の伝送容量を有する無線通信の実用化をめざします。
【用語解説】
※1CMOS-IC(Complementary Metal Oxide Semiconductor-Integrated Circuit):
相補型金属酸化膜半導体で作成される集積回路。デジタル制御など大規模な機能を実現する場合に用いられます。大容量の送受信では信号量が多いためこのタイプの回路が多く用いられます。微細化により高速化が進んでいますが、高速性や高出力性の面では化合物半導体の方がすぐれています。
※2ニュースリリース2021年2月
テラヘルツ帯でのフェーズドアレイ無線機を実現~次世代無線通信システムの実用化へ大きな一歩~
https://group.ntt/jp/newsrelease/2021/02/05/210205c.html
※3III-V族の化合物IC:
周期表の13族に属する元素(ガリウム Ga、インジウム Inなど)と15族に属する元素(窒素 N、リン P、ヒ素 Asなど)による化合物からなる半導体で作られるIC。電子の走行速度が高いため、高周波を扱う素子として研究開発が進められている。なお、これらの元素は1990年改訂以前の周期表では、それぞれIII属、V族であったため、現在もその名で呼ばれる。
※4InP HBT
III-V族半導体のリン化インジウムを用いたヘテロ接合バイポーラトランジスタ。高速性と耐圧に優れるトランジスタ。
※54素子フェーズドアレイ送信モジュール
4個の送信素子を並列に配置した送信モジュール。それぞれの送信素子から出力される電波の位相や強度を制御することでビームフォーミングが可能になる。
※6パワーアンプ回路
入力された高周波信号を必要な電力にまで増幅し、アンテナに供給するための増幅回路。
※7導波管モジュール
高周波信号を伝搬させるための金属製の管(導波管)を備えた金属製のモジュール。
※8フリップチップ実装
IC同士やICと基板を接続するために金属バンプを介して実装する工法。
本件に関する報道機関からのお問い合わせ先
日本電信電話株式会社
先端技術総合研究所 広報担当
nttrd-pr@ml.ntt.com
東京工業大学
総務部 広報課
電話: 03-5734-2975 FAX: 03-5734-3661
media@jim.titech.ac.jp
ニュースリリースに記載している情報は、発表日時点のものです。
現時点では、発表日時点での情報と異なる場合がありますので、あらかじめご了承いただくとともに、ご注意をお願いいたします。
NTT STORY
NTTとともに未来を考えるWEBメディアです。














